发布时间:2012-01-18 阅读量:1218 来源: 我爱方案网 作者:
中心议题:
* 电容式微麦克风原理
* CMOS微机电麦克风电路设计
* CMOS微机电麦克风工艺分类
解决方案:
* 采用从CMOS的操作电压中抽取一个偏置电压
* 再加上一个∑-Δ ADC模数转换电路
随着智能手机的兴起,对于声音品质和轻薄短小的需求越来越受到大家的重视,近年来广泛应用的噪声抑制及回声消除技术均是为了提高声音的品质。相比于传统的驻极体式麦克风(ECM),电容式微机电麦克风采用硅半导体材料制作,这便于集成模拟放大电路及ADC(∑-Δ ADC)电路,实现模拟或数字微机电麦克风元件,以及制造微型化元件,非常适合应用于轻薄短小的便携式装置。本文针对CMOS微机电麦克风的设计与制造进行介绍,并比较纯MEMS与CMOS工艺微导入麦克风的差异。
电容式微麦克风原理
MEMS微麦克风是一种微型的传感器。其原理是利用声音变化产生的压力梯度使电容式微麦克风的声学振膜受声压干扰而产生形变,进而改变声学振膜与硅背极板之间的电容值。该电容值的变化由电容电压转换电路转化为电压值的输出变化,再经过放大电路将MEMS传感器产生得到电压放大输出,从而将声压信号转化成电压信号。在此必须采用一个高阻抗的电阻为MEMS传感器提供一个偏置电压VPP,借以在MEMS传感器上产生固定电荷,最后的输出电压将与VPP 及振膜的形变Δd成正比。振膜的形变与其刚性有关,刚性越低则形变越大;另一方面,输出电压与d(气隙)成反比,因此气隙越低,则输出电压及灵敏度越优,但这都将受限于MEMS传感器的吸合电压,也就是受限于MEMS传感器静电场的最大极限值。
CMOS微机电麦克风电路设计
在CMOS微麦克风设计中,电路是一个非常重要的环节,它将影响到微麦克风的操作、感测,以及系统的灵敏度。驻极式电容微麦克风的感应电荷由驻极体材料本身提供的驻极电荷所产生,而凝缩式电容微麦克风则是采用从CMOS的操作电压中抽取一个偏置电压,再通过一个高阻抗电阻提供给微麦克风的声学振膜来提供固定的电荷源。此时,若声学振膜受到声压驱动而产生位移变化,则电极板(感测端)的电压将会发生变化。最后,通过电路放大器将信号放大,则可实现模拟麦克风的电路设计;如果再加上一个∑-Δ ADC模数转换电路,便可完成数字麦克风的电路设计(一般数字麦克风的输出信号为1比特PDM输出)。
CMOS微机电麦克风工艺分类
从微机电麦克风的制造来看,就目前的技术层面而言,集成CMOS电路的MEMS元件可分为三种。Pre-CMOS MEMS工艺:先制作MEMS结构,再制作CMOS元件;Intra-CMOS MEMS工艺:CMOS与MEMS元件工艺混合制造;Post-CMOS MEMS工艺:先实现CMOS元件,再进行MEMS结构制造。一般而言,前两种方法无法在传统的晶圆厂进行,而Post-CMOS MEMS则可以在半导体晶圆代工厂进行生产。
下图简述了Post-CMOS MEMS的制造方式。在Post-CMOS MEMS工艺中需特别注意,不能让额外的热处理或高温工艺影响到CMOS组件的物理特性及MEMS的应力状态,以免影响到振膜的初始应力。鑫创科技公司克服了诸多的技术难题,完全采用标准的CMOS工艺来同时制造电路元件及微机电麦克风结构。在CMOS部分完成后,将芯片的背面研磨至适当厚度以符合封装要求。最后,利用氢氟酸溶液(HF)去除牺牲氧化物来释放悬浮结构。此外,在设计中还需考虑可完全去除牺牲材料而又不损害麦克风振膜的蚀刻方法,并应避免麦克风振膜与背电极板之间产生粘黏现象。
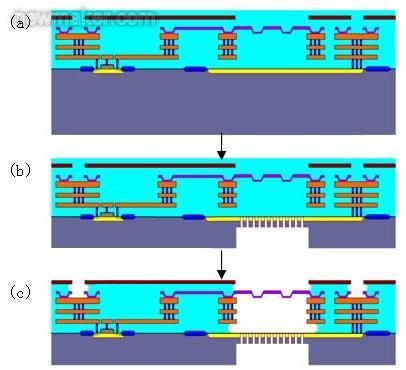
粘黏现象:由于麦克风振膜与背电极板之间的距离仅为数微米,在该尺寸下,当表面张力、范德华力、静电力、离子键等作用力大于麦克风振膜的回复力时,麦克风振膜将产生永久形变而附着于背电极板上,从而无法产生振动。通常,微机电悬浮结构粘黏现象的主要成因可以分为两类:第一类发生在麦克风振膜释放后,麦克风振膜受到表面张力影响,因而被拉近到与背电极板的距离非常靠近,若此时范德华力或氢键力等表面力大于麦克风振膜的回复力,则结构将产生粘黏现象而无法回复;第二类是悬浮结构在使用中受到外力冲击或是静电力吸引而落入表面力较回复力大的区域,则也会发生粘黏现象。因此,在结构设计上,必须特别考虑麦克风振膜在释放后的结构变形问题,并在重要的结构部位予以强化,利用特殊设计来减少粘黏现象的发生。
纯MEMS与CMOS工艺的差异
多数企业所开发的MEMS微麦克风主要分为两种形态:第一种是利用专业的MEMS代工厂制造出MEMS IC,再加上一个ASIC放大器,将MEMS IC及ASIC IC用SIP封装方式封装成MEMS麦克风芯片。这一部分在IC封装过程中必须保护振膜不被破坏,其封装成本相对较高;另一种是先利用CMOS晶圆厂制造出ASIC部分,再利用后工艺来形成MEMS的结构部分。其MEMS工艺技术目前似乎还无法在标准的CMOS晶圆厂完成,这主要是由于振膜需沉积高分子聚合物材料,而高分子聚合物材料还未用于目前的标准半导体IC工艺。另外,在CMOS工艺完成后,需分别在芯片的正面蚀刻出振膜并在其背面蚀刻出腔体及声学孔。该步骤通过载体晶圆(Carrier Wafer)来完成,在标准的CMOS铸造厂目前尚未创建出这样的环境。
目前,最大的课题是如何突破这两种形态MEMS麦克风的封装技术。其专利均由美国的微麦克风企业所掌控,因此,MEMS麦克风市场占有率主要分布在少数企业手上。
有厂家采取的方式是在CMOS工艺完成后,从芯片的背面形成腔体和声学孔作为MEMS结构的释放。这一部分无需使用特殊的机器和材料,可在现有的CMOS晶圆厂内完成,因而能够降低开发成本。另外,有些产品可直接利用晶圆级封装技术将CMOS电路与微麦克风集成在同一块芯片上,同样可避免在封装过程中对振膜产生破坏。
MEMS麦克风目前已经取代ECM麦克风被广泛应用于手机中(尤其是智能手机),其主要原因是MEMS麦克风具有耐候性佳、尺寸小及易于数字化的优点。MEMS麦克风采用半导体材质,特性稳定,不会受到环境温湿度的影响而发生改变,因而可以维持稳定的音质。电子产品组装在过锡炉时的温度高达 260℃,常会破坏ECM麦克风的振膜而必须返工,这将增加额外的成本。采用MEMS麦克风则不会因为锡炉的高温而影响到材质,适合于SMT的自动组装。麦克风信号在数字化后,可以对其进行去噪、声音集束及回声消除等信号处理,从而能够提供优异的通话品质。目前已有多款智能手机采用数字化技术,在功能手机中也有加速采用的迹象。此外,笔记本电脑也是目前使用MEMS麦克风的主流,而机顶盒生产企业同样在积极尝试将MEMS麦克风应用于开发声控型机顶盒。

紫晶存储犯欺诈发行证券罪,判处罚金人民币3700万元;公司实际控制人郑穆、罗铁威及原财务总监李燕霞等10名核心管理人员,全部被判处有期徒刑,刑期最高达七年六个月。

近日,日产汽车和总部位于英国的自动驾驶初创公司Wayve签署协议,合作开发基于人工智能的驾驶辅助系统。

京东开启招聘存算一体芯片设计工程师计划,薪酬高达“40K-100K*20薪”

日本芯片制造商铠侠(Kioxia)计划于2026年在其岩手县晶圆厂开始生产新一代NAND闪存芯片。

一系列诉讼指控芯片制造商英特尔、AMD及德州仪器公司,未能有效阻止其技术被用于俄罗斯制造的武器。