发布时间:2020-10-20 阅读量:1306 来源: 我爱方案网 作者: 我爱方案网
孔损一般是由于断钻咀后取钻咀;钻孔时没有铝片或夹反底版;参数错误;钻咀拉长; 钻咀的有效长度不能满足钻孔蟊板厚度需要; 手钻孔;板材特殊,批锋造成。解决方法可进行排查断刀原因,作出正确的处理。

铝片和底版都起到保护孔环作用,生产时一一定要用,可用与不可用底版分开、方向统一放置,上板前再检查一次。钻孔前,必须检查钻孔深度是否符合,每支钻咀的参数是否设置正确。钻机抓起钻咀,检查清楚钻咀所夹的位置是否正确再开机,开机时钻咀-般不可以超出压脚。在钻咀。上机前进行目测钻咀有效长度,并且对可用生产板的叠数进行测量检查。手动钻孔切割精准度、转速等不能达到要求,禁止用人手钻孔。在钻特殊板设置参数时,根据品质情况进行适当选取参数,进刀不宜太快。
对于表面贴装板,尤其是BGA及IC的贴装对导通孔塞孔要求必须平整,凸凹正负1mil,不得有导通孔边缘发红上锡;导通孔藏锡珠。热风整平的工作原理是利用热风将印制电路板表面及孔内多余焊料去掉,剩余焊料均匀覆在焊盘及无阻焊料线条及表面封装点上,是印制电路板表面处理的方式之一。
热风整平后塞孔工艺。此工艺流程为:板面阻焊→HAL→塞孔→固化。采用非塞孔流程进行生产,热风整平后用铝片网版或者挡墨网来完成客户要求所有要塞的导通孔塞孔。塞孔油墨可用感光油墨或者热固性油墨,在保证湿膜颜色一致的情况下,塞孔油墨最好采用与板面相同油墨。此工艺流程能保证热风整平后导通孔不掉油,但是易造成塞孔油墨污染板面、不平整。客户在贴装时易造成虚焊(尤其BGA内)。所以许多客户不接受此方法。
热风整平前塞孔工艺。用铝片塞孔、固化、磨板后进行图形转移。此工艺流程用数控钻床,钻出须塞孔的铝片,制成网版,进行塞孔,保证导通孔塞孔饱满,塞孔油墨塞孔油墨,也可用热固性油墨,其特点必须硬度大,树脂收缩变化小,与孔壁结合力好。工艺流程为:前处理→ 塞孔→磨板→图形转移→蚀刻→板面阻焊。 用此方法可以保证导通孔塞孔平整,热风整平不会有爆油、孔边掉油等质量问题,但此工艺要求一次性加厚铜,使此孔壁铜厚达到客户的标准,因此对整板镀铜要求很高,且对磨板机的性能也有很高的要求,确保铜面上的树脂等彻底去掉,铜面干净,不被污染。许多PCB厂没有一次性加厚铜工艺,以及设备的性能达不到要求,造成此工艺在PCB厂使用不多。

板面阻焊与塞孔同时完成。此方法采用36T(43T)的丝网,安装在丝印机上,采用垫板或者钉床,在完成板面的同时,将所有的导通孔塞住,其工艺流程为:前处理--丝印--预烘--曝光--显影--固化。 此工艺流程时间短,设备的利用率高,能保证热风整平后过孔不掉油、导通孔不上锡,但是由于采用丝印进行塞孔,在过孔内存着大量空气,在固化时,空气膨胀,冲破阻焊膜,造成空洞,不平整,热风整平会有少量导通孔藏锡。目前,我公司经过大量的实验,选择不同型号的油墨及粘度,调整丝印的压力等,基本上解决了过孔空洞和不平整,已采用此工艺批量生产。

晶振的启动时间,通常是指其通电后进入稳定振荡状态所需的时间。若启动时间过长,可从以下五个常见的影响因素方面进行优化。

RTC(Real-Time Clock,实时时钟)芯片作为一种独立的专用计时器件,其核心功能包括提供稳定的日历时钟、在主电源断电后持续运行、支持定时中断以及输出高精度时间戳,为各类嵌入式系统提供可靠的时间基准。

时钟系统是保障微控制器(MCU)稳定运行的核心,而晶振作为关键时钟源,主要分为无源晶振与有源晶振两种类型。下面将围绕工作原理、硬件接口、电气特性及其在MCU中的适配场景等维度,系统解析这两类晶振与MCU之间的关联逻辑。
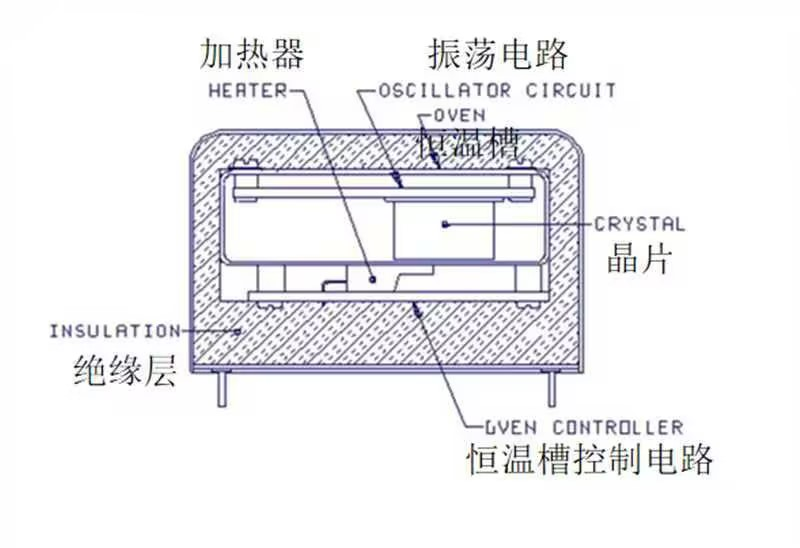
恒温晶振(Oven Controlled Crystal Oscillator,简称OCXO)是高精度频率源的核心组件,选用切型更优(如SC切、AT切高精度型)、封装应力极小的高Q值晶片,通过恒温槽的超精密控温,让晶振始终工作在零温度系数点,几乎消除温度引发的频率漂移。

晶振倍频干扰(即高次谐波辐射)是电磁兼容(EMC)设计中非常棘手的问题,通常表现为基频25MHz的5次、7次谐波(如125MHz、175MHz等)处辐射超标。该问题源于晶振输出方波信号包含丰富的高次谐波成分,若PCB布局不当,晶振及其走线极易构成高效辐射天线,导致电磁干扰增强。