发布时间:2020-12-14 阅读量:1384 来源: 我爱方案网 作者: 我爱方案网
传统上在RF测试领域,晶片探针测试通常最后会被封装测试代替,这是因为早期的晶片探针和晶片探针接口的设计难于处理在RF频段上接口之间产生的寄生电容和电感问题,噪声的处理同样也是一个大的问题,然而,随着SIP的出现使封装更复杂和相应的封装成本上升,以及直接销售,这些改变使得晶片探针测试很有必要。

而且,由于不同功能的晶粒(die)组合在一个封装里,举一个最坏的情况,一个良率低的便宜的晶粒可能损害整个封装,使得价格昂贵的晶粒(加上封装)都没用。这些需求驱动着RF晶片探针测试技术前进。对于SIP,测试可以在封装后进行,也可以在各个部分整合之前晶片阶段进行。通常,在大部分封装测试前,各个组成的晶粒需要单独进行探针测试,对于RF芯片,现在晶片级必须进行测试,但是在过去对于RF芯片这些测试是尽量避免的。结果就是,KGD使得RF芯片的晶片探针测试逐渐成为主流。
SOC的正式定义是在单一芯片上构建一个系统,在SOC芯片中,核(Core)是在硅片级被整合的。在SIP中,同样的整合是在封装级发生的。随着SIP的出现,不同的IP可以用在同一个封装内。实际上,在某些情况下,不同厂家的晶粒(die)也可以在一起使用。在最近独立的RF芯片功能模块(如低噪声放大器,混频器等)才与数字或模拟功能模块放到同一个晶粒(die)中。RF内核放到SOC或SIP中这两种集成方法的主要不同是各自相应带来的成本好处,这些好处可以分别通过其内部使用核的函数表达,这两种集成方式的不同包括:其内核预期的良率和产品封装的成本。
就像决定是去测试各个单独内核还是测试整个SIP,这也是各个独立内核良率的函数。考虑到这里,SIP的整体良率就变成下式:YSiP=Ycore1×Ycore2×…×YcoreN因此,可以非常明显的看到,在一个SIP中有越多的核,SIP的整体良率越依赖于其封装中各个单独核的良率。而且,只要有一个良率不好的核就会导致许多其它好的核和整个封装报废。然而,从正面来看,如果制造过程得到了很好的控制并且良率很高,等到所有的晶粒被封装成SIP时,那么测试的成本就会有非常大的减少,尤其当系统级的测试得以实现时。
RS-485接口可使用一对传输线工作在半双工模式,或使用两对线(4线)工作在全双工模式,以同时发送和接收数据。半双工多点配置时可支持最多32个驱动器和多达32个接收器。市场上已经出现具有1/4单位负载甚至1/8单位负载接收器输入阻抗的新器件,例如MAX13448E,允许一条总线上挂接128至256个接收器。拥有这种增强的多点功能后,用户可构建大型RS-485串行设备网络。

接收器输入检测灵敏度为±200mV,意味着接收器只有检测到高于+200mV和低于-200mV的信号电平才识别为1或0位。在±200mV范围之内的噪声被有效屏蔽。差分信号有效消除共模噪声。最小接收器输入阻抗为12kΩ,驱动器输出电压最小值±1.5V、最大值±5V。工业应用中使用的DC - DC转换器包括高输入电压和隔离电源转换器。许多应用采用24V或48V DC分布式供电。总线电源降压转换至12V或5V后,再采用负载点转换器提供必要的供电。用于远端传感器和执行器通信的网络还需要保护措施,以防止瞬态、EMI以及地电位差的影响。
推荐阅读:

晶振的启动时间,通常是指其通电后进入稳定振荡状态所需的时间。若启动时间过长,可从以下五个常见的影响因素方面进行优化。

RTC(Real-Time Clock,实时时钟)芯片作为一种独立的专用计时器件,其核心功能包括提供稳定的日历时钟、在主电源断电后持续运行、支持定时中断以及输出高精度时间戳,为各类嵌入式系统提供可靠的时间基准。

时钟系统是保障微控制器(MCU)稳定运行的核心,而晶振作为关键时钟源,主要分为无源晶振与有源晶振两种类型。下面将围绕工作原理、硬件接口、电气特性及其在MCU中的适配场景等维度,系统解析这两类晶振与MCU之间的关联逻辑。
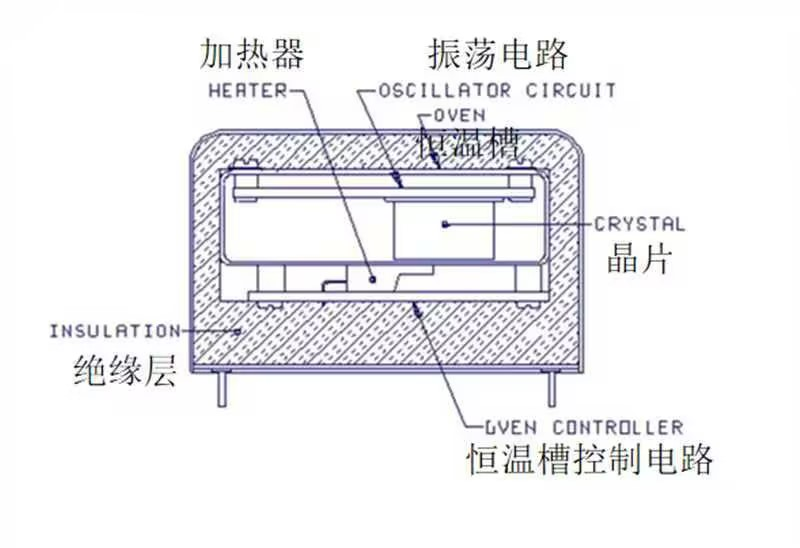
恒温晶振(Oven Controlled Crystal Oscillator,简称OCXO)是高精度频率源的核心组件,选用切型更优(如SC切、AT切高精度型)、封装应力极小的高Q值晶片,通过恒温槽的超精密控温,让晶振始终工作在零温度系数点,几乎消除温度引发的频率漂移。

晶振倍频干扰(即高次谐波辐射)是电磁兼容(EMC)设计中非常棘手的问题,通常表现为基频25MHz的5次、7次谐波(如125MHz、175MHz等)处辐射超标。该问题源于晶振输出方波信号包含丰富的高次谐波成分,若PCB布局不当,晶振及其走线极易构成高效辐射天线,导致电磁干扰增强。