发布时间:2022-01-11 阅读量:1701 来源: 我爱方案网 作者: 我爱方案网汇编
半导体公司和半导体科研人员一直在寻求各种方式,来让器件问题发生在实验室中,而不是发生在现场。故障分析(FA)工程师用了无数个小时,试图了解器件为什么会发生故障,在将来怎样才能防止故障。这一点至关重要,因为许多器件用于关键事务型应用中,在这些应用中,正如阿波罗13号航天飞行首席飞控主任Gene Kranz所说,“故障绝不能成为选项”。但器件故障却经常发生。
微电子故障分析是诊断器件发生的问题所使用的主要分析方法之一,不管问题出现在铸造阶段,还是出现在应用封装使用时。半导体器件电气故障可以是功能故障,也可以是参数故障。在器件不能实现预计功能时,这种故障视为功能故障。在器件不能达到可度量特点的电气规范时,这种故障视为参数故障。泄漏电流是典型的参数故障,其可能与器件的功能无关。因此,即使器件功能正常或能够实现预计功能,其仍可能存在参数故障。
怎样执行故障分析?

图1: 吉时利为检验故障提供的I-V曲线示图仪解决方案。
半导体器件故障分析技术有很多。快速简单的验证测试需要使用源测量单元(SMU),可以以异常方式上升到I-V曲线,然后使用SMU无缝深入其行为,最大限度地减少进一步损坏(可能)已损坏的器件的风险。
在I-V曲线示图之外,测试分成破坏性测试和非破坏性测试。工程师的目标是确定导致器件故障模式的故障机制。这些故障机制既可能来自IC中潜在的问题线路,也可能来自本地散热,还可能来自电源或信号线之间的短路、氧化物或联结击穿、闭锁等等。遗憾的是,破坏性测试通常在大部分分析工作中必不可少。开封、金属线切割、横截面等任务都属于破坏性测试技术。如果过早地执行这些程序,那么会导致不可逆转的损坏和毁坏式分析,而忽略了为此付出的资源代价。
非破坏性故障评测在历史上一直是一种可视化流程,使用传输电子显微镜和X射线检测系统之类的工具来完成。这些工具的价格非常高。比较经济的另一种技术是锁定热成像技术(LiT)。LiT解决了客户面临的多个挑战:
· 不想破坏宝贵的被测器件(DUT)。
· 需要一种简便的方式,定期调试DUT中消耗的功率的幅度。
· 更快地隔离封装器件中的问题站点或热点,降低成本,更快地找到所需信息。

图2: 锁定热成像技术可以迅速识别封装半导体器件中的热点。霍尔传感器电路2的幅度图像(a),相位图像(b),ε校正后0°图像(c; b中指明区域的0°/-90°图像),从(c)中以数字方式去卷积的功耗(d)。
为什么采用锁定热成像技术?
锁定热成像技术是一种有源热成像技术,用来分析微电子器件或比较常用的材料样本,以检测缺陷、损坏,或表征潜在的铸造问题。LiT允许使用红外热成像摄像机,无接触测量表面温度。之所以叫“锁定”,是因为摄像机的采集速率必须与电路激发同步。
LiT以脉冲式电信号的形式对被测器件应用定期热激发,然后使用热成像摄像机监测温度变化。热成像摄像机捕获多个快速采集,使用后处理算法进行计算。对半导体封装器件,故障分析工程师可以勘测封装表面,迅速识别局部化热点,提高封装表面的分辨率和温度分布。
泰克/吉时利为锁定热成像技术搭建有效的解决方案
典型的锁定热成像技术系统图如图3所示。

图3: 典型的锁定热成像技术系统的方框图。1
可以使用相应的可编程任意函数发生器、电压脉冲源或电流源发生器,而不是硬件计数器和脉冲式电源,来满足上面的应用。例如,电流脉冲器可以输出脉宽非常小的高达10 A @ 10 V的电流脉冲。
许多故障分析工程师需要全内置仪器来应对挑战,这种仪器要包括内置编程功能协调分析过程,并包括锁定功能及热成像摄像机。为此,泰克科技旗下公司吉时利开发了2601B-PULSE System SourceMeter? 10 μs脉冲器/SMU仪器。

图4: 吉时利2601B-PULSE系统源表10 μs脉冲器/SMU仪器。
2601B-PULSE是一种高电流/高速脉冲器,拥有测量功能及传统源测量单元的全部功能。这种新型脉冲器提供了领先的10 A @ 10 V电流脉冲输出,最小脉宽10 μs,并拥有快速上升时间,如图5所示。

图5: 高保真10A、10ms脉冲,用于故障器件。
该仪器还有一种内置定时器功能,不再需要使用外部时间基准。内置定时器有一个自由运行的47位计数器及1 MHz时钟输入。定时器的分辨率为1 μs,准确度为±100 ppm。根据图3中的示意图,2601B-PULSE代替了脉冲式电源和硬件计数器。
通过使用2601B-PULSE脉冲器/SMU及支持LAN/以太网的红外热成像摄像机,您可以简化锁定热成像技术配置,允许2601B-PULSE控制测试过程,同时使用PC运行热量分析软件,如图6所示。

图6: 采用Keithley 2601B-PULSE的锁定热成像技术系统实例。
锁定热成像技术只是迅速识别器件热点,缩小故障位置范围,进而调查确定故障根本原因的技术之一。Keithley 2601B-PULSE之类的仪器和支持LAN/以太网的红外热成像摄像机相结合,最大限度地减少了集成先进仪器进行测量的挑战。锁定热成像技术减少了破坏性测试需求,帮助克服在封装级进行故障分析时面临的挑战,加快获得所需信息的速度,提高故障分析工程师的时间利用效率,节约机构成本。

碳化硅(SiC)功率器件正以颠覆性优势引领工业充电器变革——其超快开关速度与超低损耗特性,驱动功率密度实现跨越式提升,同时解锁了传统IGBT无法企及的新型拓扑架构。面对工业应用对高效隔离式DC-DC转换的严苛需求,本文将深入解析从600W至深入解析从600W至30kW全功率段的拓扑选型策略,揭示SiC技术如何成为高功率密度设计的核心引擎。
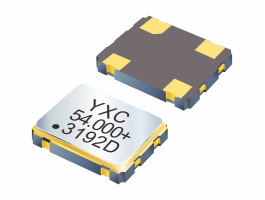
在汽车电子智能化、网联化与电动化深度融合的浪潮中,车载时钟系统的精度与可靠性正成为决定整车性能的核心命脉。作为电子架构的"精准心跳之源",车规级晶振的选型直接影响ADAS感知、实时通信、动力控制等关键功能的稳定性。面对严苛路况、极端温差及十年以上的生命周期挑战,工程师亟需兼具高稳定性与强抗干扰能力的时钟解决方案——小扬科技将聚焦车规级晶体/晶振核心参数,3分钟助您精准锁定最优型号。
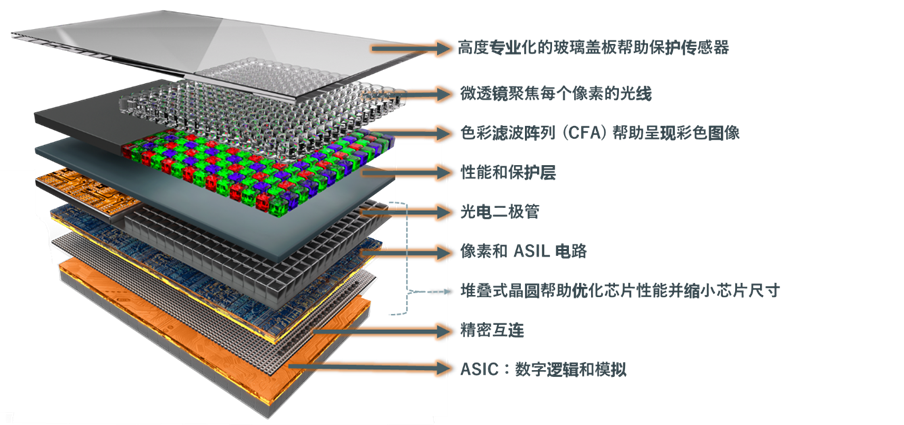
在技术创新的浪潮中,图像传感器的选型是设计与开发各类设备(涵盖专业与家庭安防系统、机器人、条码扫描仪、工厂自动化、设备检测、汽车等)过程中的关键环节。选择最适配的图像传感器需要对众多标准进行复杂的综合评估,每个标准都直接影响最终产品的性能和功能。从光学格式(Optical Format)和动态范围(Dynamic Range),到色彩滤波阵列(CFA)、像素类型、功耗及特性集成,这些考量因素多样且相互交织、错综复杂。
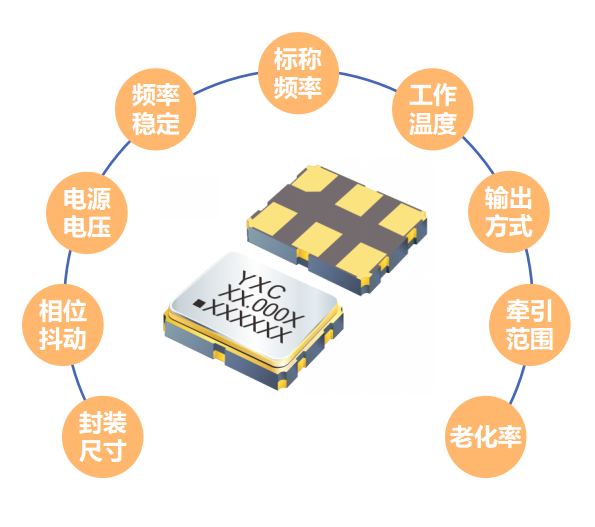
压控晶振(VCXO)作为频率调控的核心器件,已从基础时钟源升级为智能系统的"频率舵手"。通过变容二极管与石英晶体的精密耦合,实现电压-频率的线性转换,其相位噪声控制突破-160dBc/Hz@1kHz,抖动进入亚纳秒时代(0.15ps)。在5G-A/6G预研、224G光通信及自动驾驶多传感器同步场景中,VCXO正经历微型化(2016封装)、多协议兼容(LVDS/HCSL/CML集成)及温漂补偿算法的三重技术迭代。
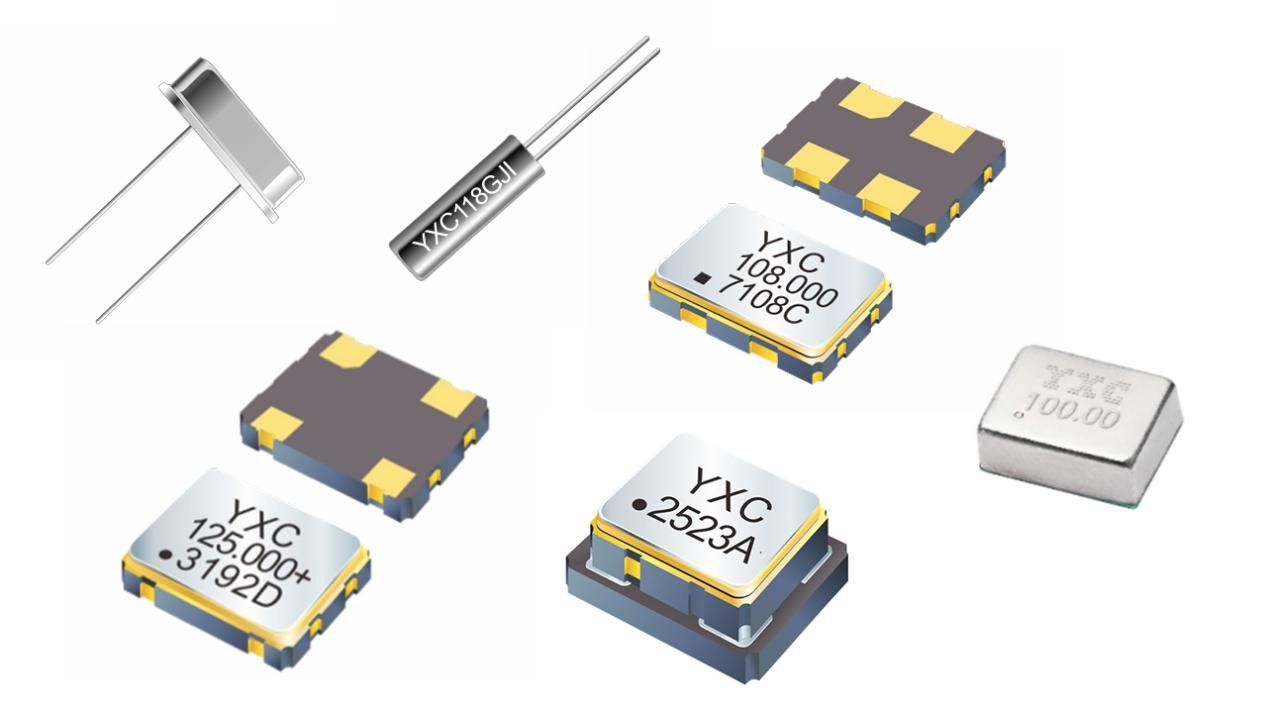
在电子设备的精密计时体系中,晶体振荡器与实时时钟芯片如同时间系统的"心脏"与"大脑":晶振通过石英晶体的压电效应产生基础频率脉冲,为系统注入精准的"生命节拍";而实时时钟芯片则承担时序调度中枢的角色,将原始频率转化为可追踪的年月日时分秒,并实现闹钟、断电计时等高级功能。二者协同构建现代电子设备的"时间维度"。