发布时间:2025-04-1 阅读量:4516 来源: 综合自网络 发布人: wenwei
【导读】2025年,随着生成式AI大模型对算力的需求呈指数级增长,高带宽内存(HBM)技术进入新一轮技术革命周期。作为AI服务器的“血液”,HBM4的研发与量产成为全球半导体产业的核心战场。SK海力士率先亮剑,于3月向客户交付12层HBM4样品,实测良率突破70%;三星则加速推进4nm逻辑芯片制程的HBM4试产,计划下半年量产;美光虽进度稍缓,却以“跳过HBM3直攻HBM3E”的策略蓄力反扑。与此同时,台积电与SK海力士的深度联盟,以及混合键合技术的突破性应用,正在重塑HBM产业链格局。这场技术角逐的背后,是英伟达Rubin GPU等AI芯片对HBM4高达2TB/s带宽的迫切需求,而全球HBM市场规模预计在2025年突破百亿美元,年增长率达40%。从封装技术革新到供应链话语权争夺,HBM4的竞争已不仅是性能之战,更是定义下一代计算生态的生死博弈。

一、定制化HBM需求激增:AI驱动下的市场爆发
2025年,生成式AI和超大规模计算的需求持续井喷,定制化高带宽内存(HBM)成为全球半导体行业争夺的焦点。据Counterpoint预测,至2026年HBM4推出时,定制化HBM市场规模将实现30%-40%的年增长率,2030年其占整体HBM市场的份额有望突破40%。驱动这一增长的核心因素包括:
● 算力瓶颈突破需求:AI训练模型参数规模已突破万亿级,传统标准HBM的带宽和容量难以满足低延迟、高吞吐量的需求。
● 成本与性能平衡:企业通过定制化方案优化功耗(如功耗降低15%-30%)和散热,同时减少芯片面积占用,提升能效比。
● 产业链协同创新:英伟达、亚马逊等巨头联合SK海力士、三星等内存厂商,推动HBM与GPU/ASIC的深度耦合设计。
二、技术路线之争:HBM4与定制化封装双轨并行
1. HBM4:逻辑制程Base Die + 混合键合技术
● Base Die革新:HBM4将基础裸晶(Base Die)从传统DRAM制程转向逻辑芯片制程,由台积电等晶圆代工厂生产,显著提升信号处理效率和I/O密度。SK海力士计划2025年量产12层HBM4,带宽达2TB/s。
● 混合键合(Hybrid Bonding):取代传统微凸块,通过铜-铜直接键合减少层间距离,提升堆叠层数至16层以上,同时降低电阻和功耗。
2. 定制化封装架构:SoC集成与异构堆叠
● HBM直连SoC:通过省略中介层(Interposer)和基底芯片,将HBM堆叠直接封装至处理器,减少信号延迟并降低成本,但面临散热和容量扩展挑战。
● cHBM(定制HBM):Marvell联合美光等推出定制接口方案,优化D2D互连,使逻辑芯片面积增加25%,内存带宽提升至20 Tbps/mm,专供边缘AI和复杂计算场景。
三、供应链重构:台积电联盟与韩厂技术竞速
● SK海力士-台积电联盟:双方合作开发HBM4基础芯片,采用台积电12FFC+和5nm工艺,结合CoWoS-L封装技术,支持8个HBM4堆叠和2000+互连,目标锁定英伟达Rubin架构GPU。
● 三星反攻策略:加速4nm逻辑芯片制程导入HBM4,并开发“VCS”阶梯堆叠技术,计划2028年推出移动端LPW DRAM,与苹果、特斯拉合作自动驾驶和AI训练。
● 美光布局:聚焦HBM3E量产,通过优化TSV工艺降低成本,但定制化进度落后韩厂,2026年或成关键转折点。
四、创新技术突破:光子通信与国产化突围
● 光子信号传输:利用光信号替代电子传输,降低延迟至纳秒级,SK海力士试验性方案已实现带宽翻倍,但面临集成度和成本挑战。
● 国产化进程:中国厂商如通富微电、华海诚科在TSV电镀液、环氧塑封料(EMC)等材料环节突破,部分产品进入三星供应链,但核心设备仍依赖进口。
五、挑战与未来趋势:标准化与成本博弈
● 标准化阻力:2028年后,软硬件标准化可能导致定制化HBM市场增速放缓,企业倾向通用解决方案以降低开发成本。
● 散热与良率难题:16层以上堆叠需引入液冷和先进MR-MUF封装材料,当前量产良率仅70%-80%,制约大规模商用。
● 应用场景扩展:从数据中心向自动驾驶(如特斯拉Dojo)、移动终端(三星VCS技术)延伸,定制化方案将覆盖边缘计算到超算全场景。
结语
2025-2026年将是定制化HBM技术落地的关键窗口期,韩厂与台积电的联盟或重塑全球内存产业格局,而光子集成、国产材料等创新方向将开辟新赛道。随着AI算力需求指数级增长,定制化HBM不仅是技术竞赛的焦点,更是下一代计算生态的核心基石。
推荐阅读:
全球半导体巨头联手布局 意法半导体与英诺赛科达成氮化镓战略合作
国产芯片逆袭样本:解码上海贝岭28亿营收背后的「技术纵贯线」
全球红外成像市场2024年突破百亿,技术创新驱动应用场景多元化
Littelfuse推出耐用性升级版PTS845轻触开关:以百万次寿命助力高端设备微型化设计
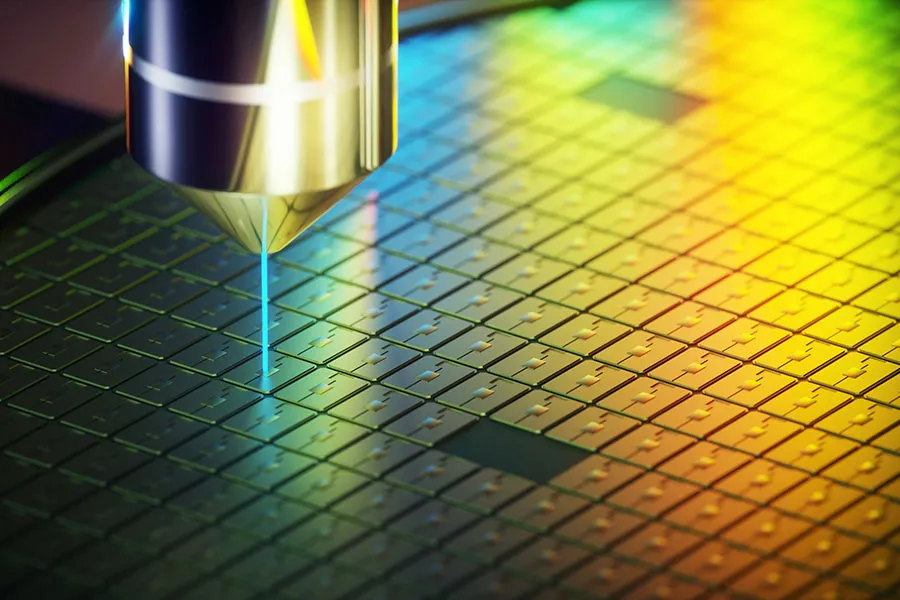
三星电子晶圆代工业务部门已设定目标,计划在2030年前推出被誉为“梦想半导体”工艺的1nm技术。

EV-B系列继电器具有高耐用性与高效性能,适用于多种应用场景,包括电动汽车 (EV)、快速充电和充电站场景

普冉半导体决定自2026年4月15日起,对通用MCU相关产品价格进行上调。

今日,第十四届中国电子信息博览会(CITE 2026)组委会在深圳召开新闻发布会,正式宣布本届博览会将于4月9日至11日在深圳会展中心(福田)举办。

黑客利用Trivy供应链攻击中窃取的凭证,成功突破思科安全防线。