发布时间:2025-07-23 阅读量:1596 来源: 我爱方案网 作者: wenwei
【导读】随着高带宽存储器(HBM)层数突破16层,三星电子正式宣布其技术路线图变革。在韩国半导体产业协会近期举办的研讨会上,三星DS部门半导体研究所常务董事金大宇指出:"现有热压键合(TC)技术难以支撑16层以上HBM制造,混合键合(Hybrid Bonding)将从HBM4E起逐步导入。"这一技术迭代标志着HBM堆叠工艺进入新阶段。
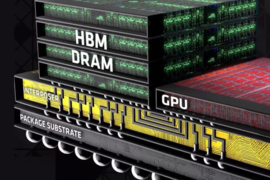
技术瓶颈驱动工艺革新
当前量产的最先进HBM3E产品最高支持12层堆叠,仍采用TC键合技术。但随着层数增加,微凸块(Microbump)焊球导致的厚度累积和信号衰减问题日益凸显。混合键合通过铜-铜直接互连替代传统焊球,使芯片间隙缩小至微米级,不仅降低30%以上堆叠高度,更显著提升散热效率与数据传输稳定性。金大宇强调:"当互连间距低于15μm时,混合键合是唯一可行方案。"
分阶段技术路线图曝光
三星披露的演进路径显示:
● 第七代HBM4E(16层):TC键合与混合键合技术并行应用
● 第八代HBM5(20层):全面转向混合键合量产 这一过渡策略既保障技术可靠性,又为设备升级预留窗口期。行业分析指出,2026年量产的HBM4E将成为混合键合商用化的重要跳板。
技术优势重塑竞争格局
混合键合的核心突破在于:
1. 物理性能:消除焊球使堆叠厚度减少40%,满足AI芯片紧凑设计需求
2. 电气特性:铜直连降低阻抗,支持每秒超过1TB的超高带宽
3. 热管理:金属直接接触提升3倍热传导效率,解决多层堆叠散热难题 三星已联合ASML开发专属混合键合光刻设备,同步推进材料与检测技术研发,构建全链条技术护城河。
产业链协同加速商业化
据TechInsights最新报告,混合键合设备市场将在2027年突破17亿美元,年复合增长率达62%。三星此次技术官宣,将推动全球封测巨头如台积电、Amkor加快技术落地。而SK海力士此前公布的HBM4路线图同样指向混合键合应用,巨头技术竞赛已延伸至先进封装领域。

4月2日,兆易创新宣布正式发布新一代SPI NAND Flash产品GD5F4GM7/GD5F8GM8。

标普全球Visible Alpha研究主管Melissa Otto指出,当前推动股市创纪录上涨的人工智能巨额投资正面临显著挑战,主要由于中东危机对全球经济增长前景与能源成本带来不确定性影响。

南加州大学团队研发新型存储芯片,可在 700°C 高温下稳定运行,且未出现性能退化迹象。

联发科和高通已开始下修于晶圆代工厂的4nm投片量,显示手机链景气明显降温

EM8695 RedCap模块基于Qualcomm SDX35基频处理器,为无需传统5G全速率或复杂功能的应用提供精简型5G解决方案