发布时间:2025-04-21 阅读量:1716 来源: 我爱方案网 作者:
【导读】全球半导体封装技术迎来革命性突破。三星集团旗下核心子公司三星电机(SEMCO)于6月12日宣布,其自主研发的玻璃基板技术已进入产业化倒计时阶段,计划在2027年实现规模化量产。这项技术革新将直接冲击价值580亿美元的先进封装市场。

■ 技术迭代驱动产业升级
当前半导体封装领域普遍采用有机基板(又称塑料基板),但随着AI芯片算力需求呈指数级增长,传统基板已面临物理极限。据IEEE最新研究显示,H100等高端AI芯片在运行时的热变形量已超过有机基板0.8mm/m的形变承受阈值。三星电机研发的玻璃基板凭借其0.05mm/m的超低翘曲特性,可将布线密度提升至现有技术的4倍,同时热膨胀系数(CTE)稳定在3.2ppm/°C,较有机基板提升75%的尺寸稳定性。
■ 技术参数全面领先
从实验室数据看,玻璃基板展现出三大核心优势:
1)信号完整性提升:50μm间距下实现1.6Tbps/mm²的互连密度
2)能效突破:通过3D硅通孔(TSV)技术降低30%的功率损耗
3)散热优化:导热系数达5W/mK,支持5kW/cm²的热流密度
三星电机研究院副总裁Joo Hyuk透露,已与康宁公司合作开发出厚度可控在100-300μm的硼硅酸盐玻璃基板,其表面粗糙度(Ra)控制在20nm以内,远超行业标准。
■ 构建产业生态联盟
三星电机正加速构建"玻璃基板生态共同体",已确认的合作伙伴包括:
● 设备端:应用材料(刻蚀设备)、ASML(光刻解决方案)
● 材料端:信越化学(封装树脂)、JSR(光敏介电材料)
● 设计端:联合Cadence开发专用EDA工具链
值得注意的是,该联盟已获得包括英伟达、AMD在内的5家顶级芯片设计公司技术验证,其中HBM4存储堆叠方案测试通过率高达99.3%。
■ 量产布局紧锣密鼓
位于韩国世宗的示范工厂已完成首条试验线建设,采用AI驱动的视觉检测系统实现0.1μm级缺陷检测。按照规划,2024Q3将完成200mm晶圆试产,2025年转入300mm晶圆阶段。市场分析师预测,玻璃基板封装芯片将在2028年占据37%的高性能计算市场份额。

韩国OLED沉积设备大厂YAS近期斩获TCL华星订单,将为后者8.6代OLED产线供应蒸发源。
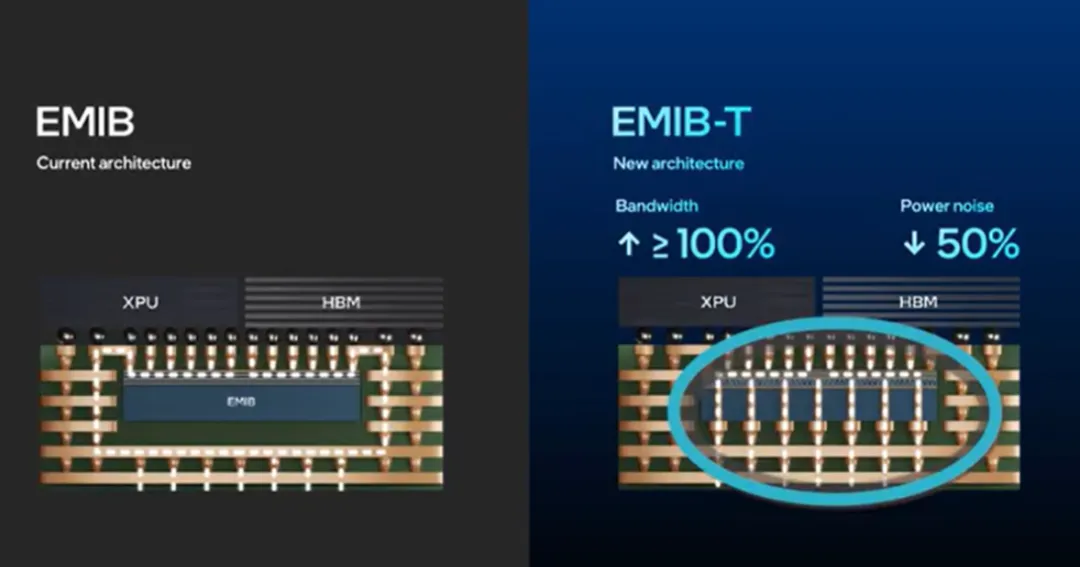
英特尔旗下晶圆代工业务 Intel Foundry 近日发布了新一代 EMIB(Embedded Multi-Die Interconnect Bridge,嵌入式多芯片互连桥接)先进封装技术——EMIB-T。

黄仁勋透露,中国台湾新总部将延续加州总部设计风格,预计2030年入驻。该基地规划面积约70万平方英尺,可容纳约4000名员工。

三星电子工会成员投票批准了上周敲定的奖金方案,终结了存储芯片业务部门此前的罢工危机。

据THE ELEC报道,韩国化工企业PKC宣布将在全罗北道群山工厂把半导体用高纯度氯气(Cl₂)产能提升50%,年产能由1400–1500吨扩至2100–2200吨